
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
فهم عملية تصنيع جهاز أشباه الموصلات الكاملة
1. الطباعة الحجرية الضوئية
تعد الطباعة الحجرية الضوئية، التي غالبًا ما تكون مرادفة لتوليد الأنماط، إحدى القوى الدافعة الأكثر أهمية وراء التقدم السريع في تكنولوجيا أشباه الموصلات، والتي تنشأ من عمليات صنع الألواح الفوتوغرافية في الطباعة. وتسمح هذه التقنية بعرض أي نمط على نطاق صغير أو نانوي باستخدام مقاوم الضوء، وعند دمجه مع تقنيات المعالجة الأخرى، فإنه ينقل هذه الأنماط إلى المواد، مما يحقق تصميمات ومفاهيم مختلفة للمواد والأجهزة شبه الموصلة. يؤثر مصدر الضوء المستخدم في الطباعة الحجرية الضوئية بشكل مباشر على دقة الأنماط، مع خيارات تتراوح من الأشعة فوق البنفسجية، والأشعة فوق البنفسجية العميقة، إلى الأشعة السينية، وحزم الإلكترون، كل منها يتوافق مع مستويات متزايدة من دقة النمط بالترتيب المذكور.
يشتمل تدفق عملية الطباعة الحجرية الضوئية القياسية على إعداد السطح، والالتصاق، والخبز الناعم، والتعرض، والخبز بعد التعرض، والتطوير، والخبز الصلب، والفحص.
تعد المعالجة السطحية أمرًا ضروريًا لأن الركائز تمتص عادةً جزيئات H2O من الهواء، وهو ما يضر بالطباعة الحجرية الضوئية. لذلك، تخضع الركائز في البداية لمعالجة الجفاف من خلال الخبز.
بالنسبة للركائز المحبة للماء، فإن التصاقها بمقاوم الضوء الكاره للماء غير كافٍ، مما قد يتسبب في انفصال مقاوم الضوء أو اختلال النمط، وبالتالي الحاجة إلى مروج الالتصاق. حاليًا، يتم استخدام سداسي ميثيل ديسيلازان (HMDS) وثلاثي ميثيل سيليل ثنائي إيثيل أمين (TMSDEA) على نطاق واسع من معززات الالتصاق.
بعد معالجة السطح، يبدأ تطبيق مقاوم الضوء. لا يرتبط سمك مقاوم الضوء المطبق بلزوجته فحسب، بل يتأثر أيضًا بسرعة طلاء الدوران، والتي تتناسب بشكل عام عكسًا مع الجذر التربيعي لسرعة الدوران. بعد الطلاء، يتم إجراء خبز ناعم لتبخير المذيب من مقاوم الضوء، مما يحسن الالتصاق في عملية تعرف باسم الخبز المسبق.
بمجرد اكتمال هذه الخطوات، يتم التعرض. يتم تصنيف مقاومات الضوء على أنها إيجابية أو سلبية، مع خصائص معاكسة بعد التعرض.
خذ مقاومة الضوء الإيجابية كمثال، حيث تكون مقاومة الضوء غير المكشوفة غير قابلة للذوبان في المطور، ولكنها تصبح قابلة للذوبان بعد التعرض. أثناء التعرض، يضيء مصدر الضوء، الذي يمر عبر قناع منقوش، الركيزة المطلية، مما يؤدي إلى تنميط مقاوم الضوء. عادةً، يجب محاذاة الركيزة مع القناع قبل التعرض للتحكم في موضع التعرض بدقة. يجب إدارة مدة التعرض بشكل صارم لمنع تشويه النمط. بعد التعرض، قد تكون هناك حاجة إلى خبز إضافي للتخفيف من آثار الموجة الدائمة، على الرغم من أن هذه الخطوة اختيارية ويمكن تجاوزها لصالح التطوير المباشر. يؤدي التطوير إلى إذابة مقاوم الضوء المكشوف، ونقل نمط القناع بدقة إلى طبقة مقاوم الضوء. يعتبر وقت التطوير أيضًا أمرًا بالغ الأهمية، فالقصير جدًا يؤدي إلى تطوير غير مكتمل، والطويل جدًا يؤدي إلى تشويه النمط.
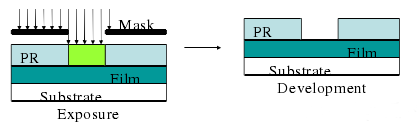
بعد ذلك، يؤدي الخبز الصلب إلى تقوية التصاق الطبقة المقاومة للضوء بالركيزة وتحسين مقاومتها للحفر. تكون درجة حرارة الخبز الصلب أعلى قليلاً بشكل عام من درجة حرارة الخبز المسبق.
وأخيرًا، يتحقق الفحص المجهري مما إذا كان النمط يتوافق مع التوقعات. بعد أن يتم نقل النموذج إلى المادة من خلال عمليات أخرى، يكون مقاوم الضوء قد أدى غرضه ويجب إزالته. تشمل طرق التجريد الرطبة (باستخدام مذيبات عضوية قوية مثل الأسيتون) والجافة (باستخدام بلازما الأكسجين لحفر الفيلم).
2. تقنيات المنشطات
لا غنى عن المنشطات في تكنولوجيا أشباه الموصلات، حيث يتم تغيير الخواص الكهربائية للمواد شبه الموصلة حسب الحاجة. تشمل طرق المنشطات الشائعة الانتشار الحراري وزرع الأيونات.
(1) زرع الأيونات
تعمل عملية زرع الأيونات على تخدير الركيزة شبه الموصلة عن طريق قصفها بأيونات عالية الطاقة. بالمقارنة مع الانتشار الحراري، فإن له العديد من المزايا. الأيونات، التي تم اختيارها بواسطة محلل الكتلة، تضمن درجة نقاء عالية للمنشطات. طوال عملية الزرع، تظل الركيزة في درجة حرارة الغرفة أو أعلى قليلاً. يمكن استخدام العديد من أفلام التقنيع، مثل ثاني أكسيد السيليكون (SiO2)، ونيتريد السيليكون (Si3N4)، ومقاوم الضوء، مما يوفر مرونة عالية مع تقنيات القناع ذاتية الانحياز. يتم التحكم بدقة في جرعات الزرع، ويكون توزيع أيونات الشوائب المزروعة موحدًا داخل نفس المستوى، مما يؤدي إلى تكرار عالي.
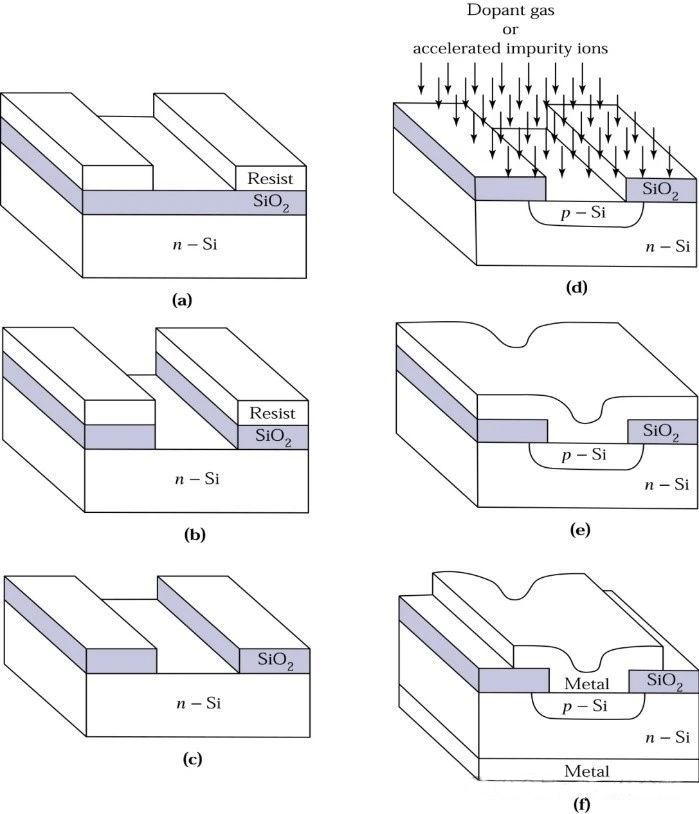
يتم تحديد عمق الزرع من خلال طاقة الأيونات. من خلال تنظيم الطاقة والجرعة، يمكن التلاعب بتوزيع أيونات الشوائب في الركيزة بعد الزرع. يمكن إجراء عمليات زرع متعددة بمخططات متنوعة بشكل مستمر لتحقيق أشكال مختلفة من الشوائب. على وجه الخصوص، في الركائز أحادية البلورة، إذا كان اتجاه الزرع موازيًا للاتجاه البلوري، تحدث تأثيرات التوجيه - ستنتقل بعض الأيونات عبر القنوات، مما يجعل التحكم في العمق أمرًا صعبًا.
لمنع التوجيه، يتم إجراء عملية الزرع عادةً بزاوية 7 درجات تقريبًا للمحور الرئيسي للركيزة أحادية البلورة أو عن طريق تغطية الركيزة بطبقة غير متبلورة.
ومع ذلك، يمكن أن يؤدي زرع الأيونات إلى إتلاف البنية البلورية للركيزة بشكل كبير. تقوم الأيونات عالية الطاقة، عند الاصطدام، بنقل الطاقة إلى النوى والإلكترونات الموجودة في الركيزة، مما يجعلها تترك الشبكة وتشكل أزواجًا من عيوب الشغور الخلالي. في الحالات الشديدة، قد يتم تدمير البنية البلورية في بعض المناطق، وتشكيل مناطق غير متبلورة.
يؤثر تلف الشبكة بشكل كبير على الخواص الكهربائية للمادة شبه الموصلة، مثل تقليل حركة الناقل أو عمر الناقلات غير المتوازنة. والأهم من ذلك، أن غالبية الشوائب المزروعة تشغل مواقع خلالية غير منتظمة، وتفشل في تكوين المنشطات الفعالة. لذلك، يعد إصلاح تلف الشبكة بعد الزرع والتنشيط الكهربائي للشوائب أمرًا ضروريًا.
(2)المعالجة الحرارية السريعة (RTP)
التلدين الحراري هو الطريقة الأكثر فعالية لتعديل تلف الشبكة الناتج عن زرع الأيونات والشوائب المنشطة كهربائيًا. في درجات الحرارة المرتفعة، سوف تتحد أزواج عيوب الفراغ الخلالي في الشبكة البلورية للركيزة وتختفي؛ سيتم أيضًا إعادة بلورة المناطق غير المتبلورة من الحدود مع مناطق أحادية البلورة عبر تنضيد الطور الصلب. لمنع المواد الأساسية من الأكسدة في درجات حرارة عالية، يجب إجراء التلدين الحراري في جو من الفراغ أو الغاز الخامل. يستغرق التلدين التقليدي وقتًا طويلاً وقد يتسبب في إعادة توزيع الشوائب بشكل كبير بسبب الانتشار.
قدومتقنية RTPيعالج هذه المشكلة، وينجز إلى حد كبير إصلاح تلف الشبكة وتنشيط الشوائب خلال مدة تلدين قصيرة.
اعتمادا على مصدر الحرارة،RTPيتم تصنيفها إلى عدة أنواع: مسح شعاع الإلكترون، وحزم الإلكترون والأيونات النبضية، والليزر النبضي، وليزر الموجة المستمرة، ومصادر الضوء غير المتماسكة عريضة النطاق (مصابيح الهالوجين، وسخانات الجرافيت، ومصابيح القوس)، والأخيرة هي الأكثر استخدامًا. يمكن لهذه المصادر تسخين الركيزة إلى درجة الحرارة المطلوبة في لحظة، وإكمال التلدين في وقت قصير وتقليل انتشار الشوائب بشكل فعال.
3. تقنيات ترسيب الأفلام
(1) ترسيب البخار الكيميائي المعزز بالبلازما (PECVD)
PECVD هو أحد أشكال تقنية ترسيب البخار الكيميائي (CVD) لترسيب الأفلام، أما النوعان الآخران فهما الضغط الجوي CVD (APCVD) والضغط CVD المنخفض (LPCVD).
حاليًا، يعد PECVD هو الأكثر تطبيقًا على نطاق واسع بين الأنواع الثلاثة. إنها تستخدم بلازما التردد الراديوي (RF) لبدء التفاعلات الكيميائية والحفاظ عليها عند درجات حرارة منخفضة نسبيًا، وبالتالي تسهيل ترسيب الأفلام في درجات الحرارة المنخفضة بمعدلات ترسيب عالية. مخطط معداتها كما هو موضح.
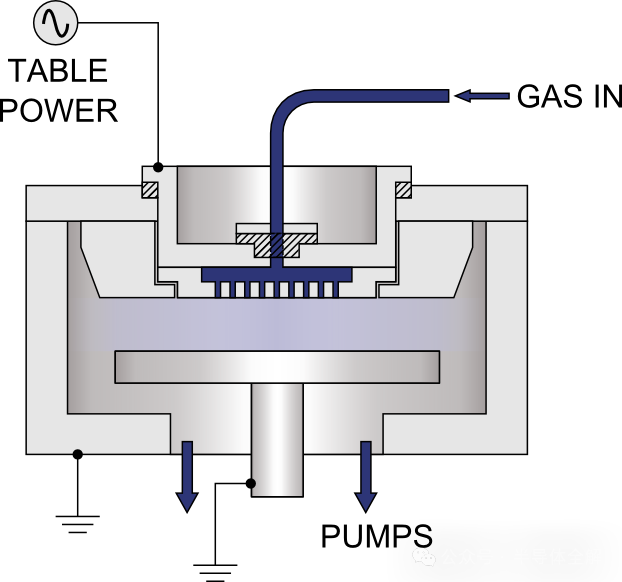
تُظهر الأفلام المنتجة عبر هذه الطريقة التصاقًا استثنائيًا وخواصًا كهربائية، والحد الأدنى من المسامية الدقيقة، والتوحيد العالي، وقدرات تعبئة قوية على نطاق صغير. تشمل العوامل التي تؤثر على جودة ترسب PECVD درجة حرارة الركيزة، ومعدل تدفق الغاز، والضغط، وطاقة التردد اللاسلكي، والتردد.
(2) الاخرق
الاخرق هو طريقة ترسيب البخار الفيزيائي (PVD). يتم تسريع الأيونات المشحونة (عادة أيونات الأرجون، Ar+) في المجال الكهربائي، وتكتسب طاقة حركية. يتم توجيهها نحو المادة المستهدفة، وتتصادم مع الجزيئات المستهدفة وتتسبب في إزاحتها وتناثرها بعيدًا. تمتلك هذه الجزيئات أيضًا طاقة حركية كبيرة وتتحرك نحو الركيزة وتترسب عليها.

تشتمل مصادر طاقة الرش المستخدمة عادة على التيار المباشر (DC) وتردد الراديو (RF)، حيث ينطبق رش التيار المستمر بشكل مباشر على المواد الموصلة مثل المعادن، في حين تتطلب المواد العازلة ترسيب الترددات اللاسلكية لترسيب الفيلم.
يعاني الرش التقليدي من انخفاض معدلات الترسيب وضغوط العمل العالية، مما يؤدي إلى انخفاض جودة الفيلم. يعالج رش المغنطرون هذه المشكلات بشكل مثالي. إنه يستخدم مجالًا مغناطيسيًا خارجيًا لتغيير المسار الخطي للأيونات إلى مسار حلزوني حول اتجاه المجال المغناطيسي، مما يؤدي إلى إطالة مسارها وتحسين كفاءة الاصطدام مع الجزيئات المستهدفة، وبالتالي تعزيز كفاءة الاخرق. يؤدي هذا إلى زيادة معدلات الترسيب، وتقليل ضغوط العمل، وتحسين جودة الفيلم بشكل ملحوظ.
4. النقش تقنيات
يتم تصنيف التنميش إلى الوضعين الجاف والرطب، ويتم تسميتهما لاستخدامهما (أو عدم وجود) لحلول محددة على التوالي.
عادةً، يتطلب النقش إعداد طبقة قناع (والتي يمكن أن تكون مقاومة للضوء بشكل مباشر) لحماية المناطق غير المخصصة للحفر.
(1) النقش الجاف
تشمل أنواع النقش الجاف الشائعةالنقش بالبلازما المقترنة حثياً (ICP).والنقش بالشعاع الأيوني (IBE) والنقش الأيوني التفاعلي (RIE).
في النقش ICP، تحتوي البلازما الناتجة عن تفريغ التوهج على العديد من الجذور الحرة النشطة كيميائيًا (الذرات الحرة أو الجزيئات أو المجموعات الذرية)، والتي تتفاعل كيميائيًا مع المادة المستهدفة لتكوين منتجات متطايرة، وبالتالي تحقيق النقش.
يستخدم IBE أيونات عالية الطاقة (متأينة من الغازات الخاملة) لقصف سطح المادة المستهدفة مباشرة للحفر، وهو ما يمثل عملية فيزيائية.
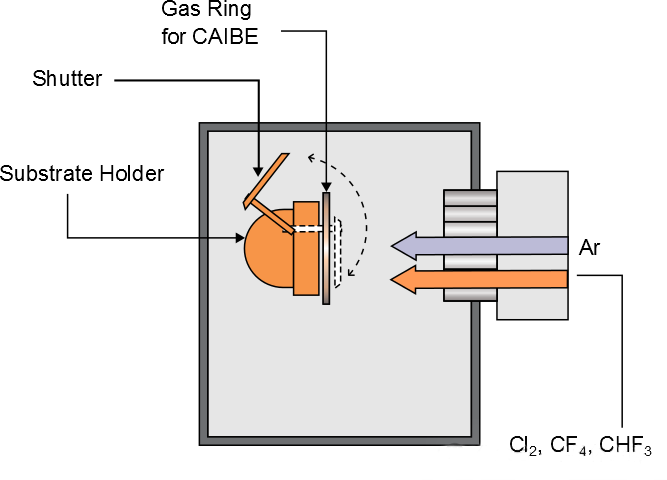
يعتبر RIE مزيجًا من الاثنين السابقين، حيث يحل محل الغاز الخامل المستخدم في IBE بالغاز المستخدم في حفر ICP، وبالتالي يشكل RIE.
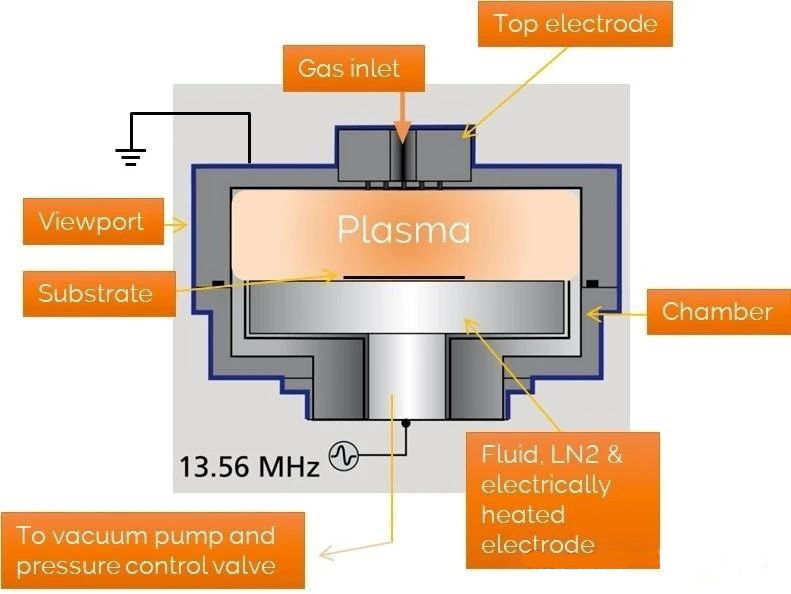
بالنسبة للحفر الجاف، فإن معدل النقش العمودي يتجاوز بكثير المعدل الجانبي، أي أنه يحتوي على نسبة عرض إلى ارتفاع عالية، مما يسمح بتكرار دقيق لنمط القناع. ومع ذلك، فإن الحفر الجاف يؤدي أيضًا إلى حفر طبقة القناع، مما يُظهر انتقائية أقل (نسبة معدلات حفر المادة المستهدفة إلى طبقة القناع)، خاصة مع IBE، الذي قد يؤدي إلى حفر غير انتقائي عبر سطح المادة.
(2) النقش الرطب
يشير النقش الرطب إلى طريقة النقش التي يتم تحقيقها عن طريق غمر المادة المستهدفة في محلول (منمش) يتفاعل معها كيميائيًا.
طريقة النقش هذه بسيطة وفعالة من حيث التكلفة وتظهر انتقائية جيدة ولكنها ذات نسبة عرض إلى ارتفاع منخفضة. يمكن أن تتآكل المادة الموجودة أسفل حواف القناع، مما يجعلها أقل دقة من الحفر الجاف. للتخفيف من الآثار السلبية لنسبة العرض إلى الارتفاع المنخفضة، يجب اختيار معدلات الحفر المناسبة. تشمل العوامل التي تؤثر على معدل النقش تركيز النقش ووقت النقش ودرجة حرارة النقش.**




