
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe في تصنيع الرقائق: تقرير إخباري احترافي
تطور مواد أشباه الموصلات
في عالم تكنولوجيا أشباه الموصلات الحديثة، أدى التوجه المستمر نحو التصغير إلى تجاوز حدود المواد التقليدية القائمة على السيليكون. لتلبية متطلبات الأداء العالي والاستهلاك المنخفض للطاقة، برزت SiGe (Silicon Germanium) كمادة مركبة مفضلة في تصنيع شرائح أشباه الموصلات نظرًا لخصائصها الفيزيائية والكهربائية الفريدة. تتعمق هذه المقالة فيعملية الفوقيةSiGe ودوره في النمو الفوقي، وتطبيقات السيليكون المتوترة، وهياكل البوابة الشاملة (GAA).

أهمية SiGe Epitaxy
1.1 مقدمة إلى Epitaxy في تصنيع الرقائق:
تشير Epitaxy، التي غالبًا ما يتم اختصارها باسم Epi، إلى نمو طبقة أحادية البلورة على ركيزة أحادية البلورة بنفس ترتيب الشبكة. يمكن أن تكون هذه الطبقة إمامتجانسة المحور (مثل Si/Si)أو غير متجانسة المحور (مثل SiGe/Si أو SiC/Si). يتم استخدام طرق مختلفة للنمو الفوقي، بما في ذلك تنضيد الشعاع الجزيئي (MBE)، وترسيب البخار الكيميائي عالي التفريغ (UHV/CVD)، ونضام الضغط الجوي المنخفض (ATM & RP Epi). تركز هذه المقالة على العمليات الفوقية للسيليكون (Si) والسيليكون الجرمانيوم (SiGe) المستخدمة على نطاق واسع في إنتاج الدوائر المتكاملة لأشباه الموصلات مع السيليكون كمادة ركيزة.
1.2 مزايا SiGe Epitaxy:
دمج نسبة معينة من الجرمانيوم (Ge) خلالعملية الفوقيةتشكل طبقة SiGe أحادية البلورة والتي لا تقلل عرض فجوة النطاق فحسب، بل تزيد أيضًا من تردد قطع الترانزستور (fT). وهذا يجعلها قابلة للتطبيق على نطاق واسع في الأجهزة عالية التردد للاتصالات اللاسلكية والبصرية. علاوة على ذلك، في عمليات الدوائر المتكاملة CMOS المتقدمة، يؤدي عدم تطابق الشبكة (حوالي 4%) بين Ge وSi إلى إجهاد الشبكة، مما يعزز حركة الإلكترونات أو الثقوب وبالتالي زيادة تيار تشبع الجهاز وسرعة الاستجابة.
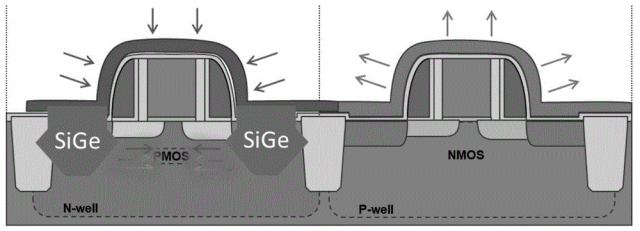
التدفق الشامل لعملية SiGe Epitaxy
2.1 المعالجة المسبقة:
تتم معالجة رقائق السيليكون مسبقًا بناءً على نتائج العملية المرغوبة، والتي تتضمن في المقام الأول إزالة طبقة الأكسيد الطبيعي والشوائب الموجودة على سطح الرقاقة. بالنسبة لرقائق الركيزة المخدرة بشدة، من الأهمية بمكان مراعاة ما إذا كان الختم الخلفي ضروريًا لتقليل المنشطات التلقائية أثناء العمليات اللاحقةالنمو الفوقي.
2.2 غازات النمو وشروطه:
غازات السيليكون: سيلاني (SiH₄)، ثنائي كلوروسيلان (DCS، SiH₂Cl₂)، وثلاثي كلوروسيلان (TCS، SiHCl₃) هي مصادر غاز السيليكون الثلاثة الأكثر استخدامًا. يعتبر SiH₄ مناسبًا للعمليات الفوقية الكاملة ذات درجات الحرارة المنخفضة، في حين يستخدم TCS، المعروف بمعدل نموه السريع، على نطاق واسع لتحضير المواد السميكة.نتاج السيليكونطبقات.
غاز الجرمانيوم: الجرمانيوم (GeH₄) هو المصدر الرئيسي لإضافة الجرمانيوم، ويستخدم مع مصادر السيليكون لتشكيل سبائك SiGe.
النضوج الانتقائي: يتم تحقيق النمو الانتقائي عن طريق ضبط المعدلات النسبية للترسب الفوقيوالحفر في الموقع، باستخدام غاز السيليكون المحتوي على الكلور DCS. ترجع الانتقائية إلى أن امتصاص ذرات الكلور على سطح السيليكون أقل من امتصاص الأكاسيد أو النتريدات، مما يسهل النمو الفوقي. يتم تطبيق SiH₄، الذي يفتقر إلى ذرات Cl ومع طاقة تنشيط منخفضة، بشكل عام فقط على عمليات النضوج الكاملة ذات درجة الحرارة المنخفضة. مصدر سيليكون آخر شائع الاستخدام، TCS، لديه ضغط بخار منخفض وهو سائل في درجة حرارة الغرفة، ويتطلب فقاعات H₂ لإدخاله إلى غرفة التفاعل. ومع ذلك، فهو غير مكلف نسبيًا وغالبًا ما يستخدم لمعدل نموه السريع (يصل إلى 5 ميكرومتر/دقيقة) لزراعة طبقات من السيليكون السميكة، والتي يتم تطبيقها على نطاق واسع في إنتاج رقائق السيليكون.
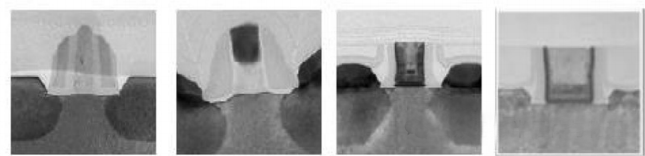
السيليكون المتوتر في الطبقات الفوقي
خلالالنمو الفوقي، يتم ترسيب Si أحادي البلورة الفوقي على طبقة SiGe مريحة. نظرًا لعدم تطابق الشبكة بين Si وSiGe، تتعرض الطبقة البلورية المفردة Si لضغط الشد من طبقة SiGe الأساسية، مما يعزز بشكل كبير حركة الإلكترون في ترانزستورات NMOS. ولا تعمل هذه التقنية على زيادة تيار التشبع (Idsat) فحسب، بل تعمل أيضًا على تحسين سرعة استجابة الجهاز. بالنسبة لأجهزة PMOS، يتم زراعة طبقات SiGe بشكل فوقي في مناطق المصدر والصرف بعد الحفر لإدخال ضغط ضاغط على القناة، مما يعزز حركة الثقب ويزيد تيار التشبع.

SiGe كطبقة مضحية في هياكل GAA
في تصنيع ترانزستورات الأسلاك النانوية ذات البوابة الشاملة (GAA)، تعمل طبقات SiGe كطبقات مضحية. تسمح تقنيات النقش متباين الخواص عالية الانتقائية، مثل حفر الطبقة شبه الذرية (شبه ALE)، بالإزالة الدقيقة لطبقات SiGe لتشكيل هياكل أسلاك متناهية الصغر أو صفائح نانوية.
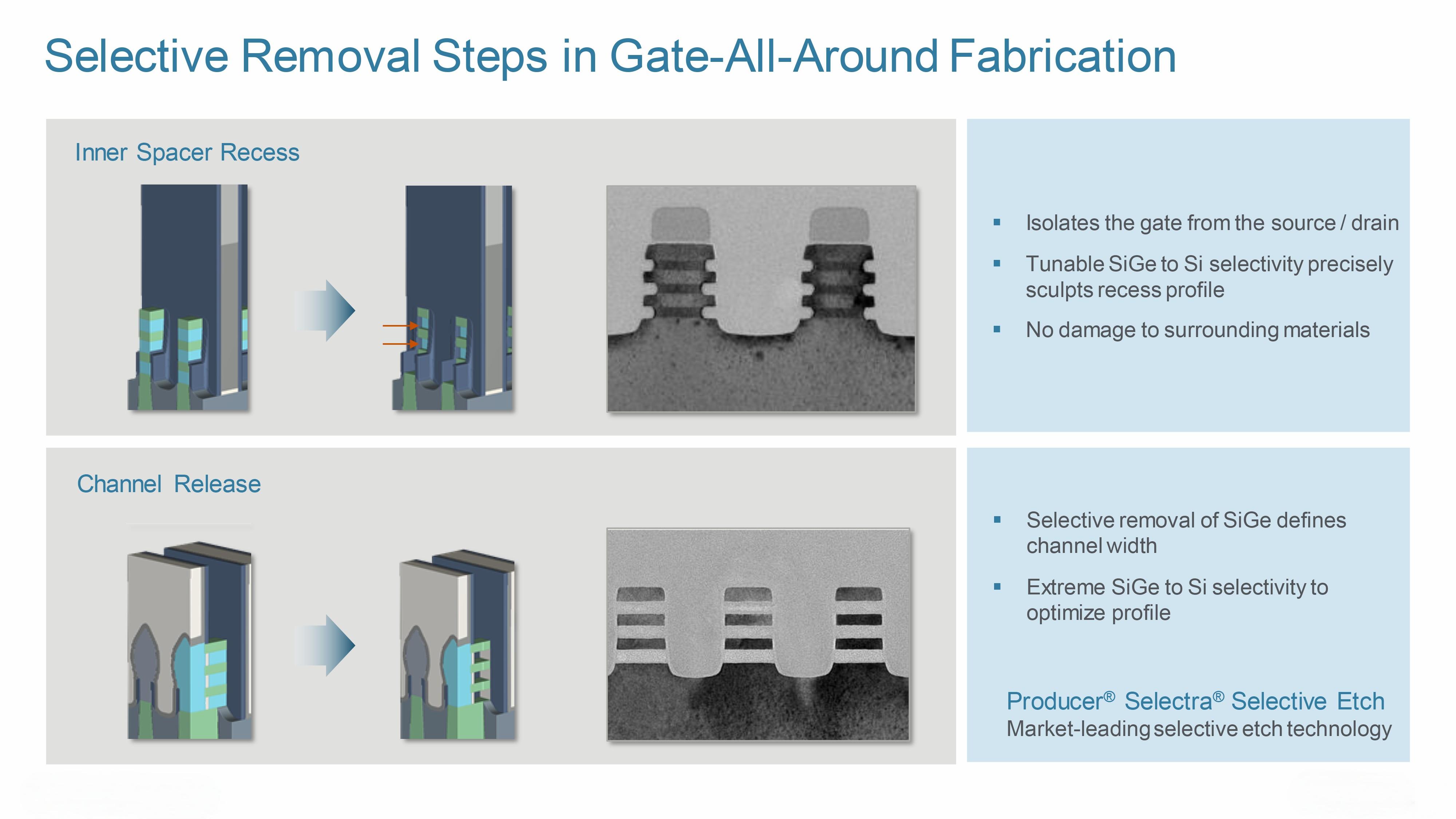
نحن في Semicorex متخصصون فيمحاليل الجرافيت المطلية بـ SiC/TaCيتم تطبيقه في النمو الفوقي لـ Si في تصنيع أشباه الموصلات، إذا كانت لديك أي استفسارات أو كنت بحاجة إلى تفاصيل إضافية، فلا تتردد في الاتصال بنا.
هاتف الاتصال: +86-13567891907
البريد الإلكتروني: sales@semicorex.com




